集束イオンビーム装置(FIB-SEM/EDS)
高精度加工・極低加速電圧加工が可能な集束イオンビーム(FIB)に、超高解像度のフィールドエミッション走査電子顕微鏡(FE-SEM)を搭載した小片試料~200mmφウェーハまでに対応したトリプルビーム装置です。
装置
集束イオンビーム装置(FIB-SEM/EDS)

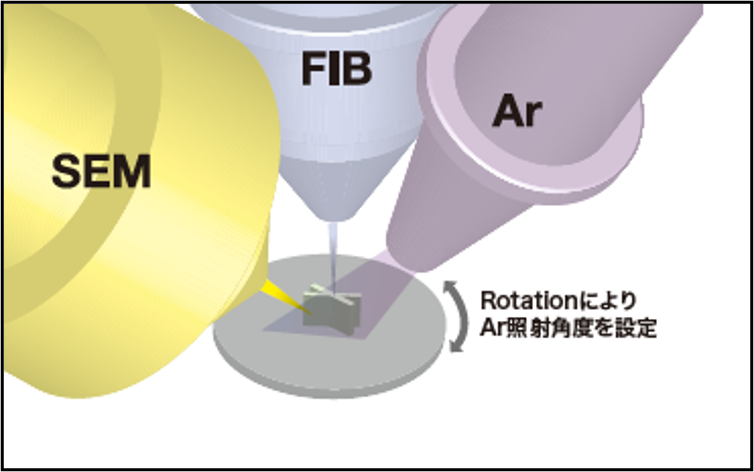
特徴
・XVision200TBにはFIB-SEM-Arの3つのビームが試料の同一位置に交差するトリプルビームシステムを採用。(左下図)
・断面加工観察・TEM試料作成およびアルゴン低加速ミリング仕上げ・EDS分析が1台で可能。
・FIB加工を中断することなく加工中の断面SEM像をリアルタイムで観察できるため、微細な加工終点を逃さずに加工可能。
・チャンバーSE検出器、InLensSE検出器、EsB反射電子検出器・EDSなど、微細化の進むデバイス解析に必須なイメージング /分析ツールを搭載。
・最大200mmφウェーハ面内の複数箇所からのTEM試料作成機能によ り、プロセス評価・故障解析に威力を発揮。
メーカー
エスアイアイ・ナノテクノロジー株式会社
型式
XVision200TB
仕様
| SEM分解能 | 3.0nm(5kV) |
| 検出器 | 二次電子検出器 反射電子検出器 |
| 推奨試料サイズ | 最大200mm径 |
| FIB分解能 | 4nm(30kV時) |
| EDS | NORAN System7 (サーモフィッシャーサイエンティフィック製) |
| 分析モード | 点分析、線分析、面分析 |
| 分析対象元素 | B~U |
| その他 | アルゴンイオンガン搭載 |
利用例