FIB-マイクロサンプリング法によるTEM試料作製事例
透過電子顕微鏡(TEM)の観察は、観察対象とするサンプルを約100nm以下の厚さに加工しなければ電子が透過しないことから、観察、分析をすることができません。
集束イオンビーム装置(FIB)で観察対象を薄片化することにより、TEM試料を作製することができます。また、局所箇所をピンポイントで加工することも可能です。
<使用機器> 集束イオンビーム装置(FIB)
<納 期> 担当職員にお問い合わせください。
<マイクロサンプリング法 加工例>

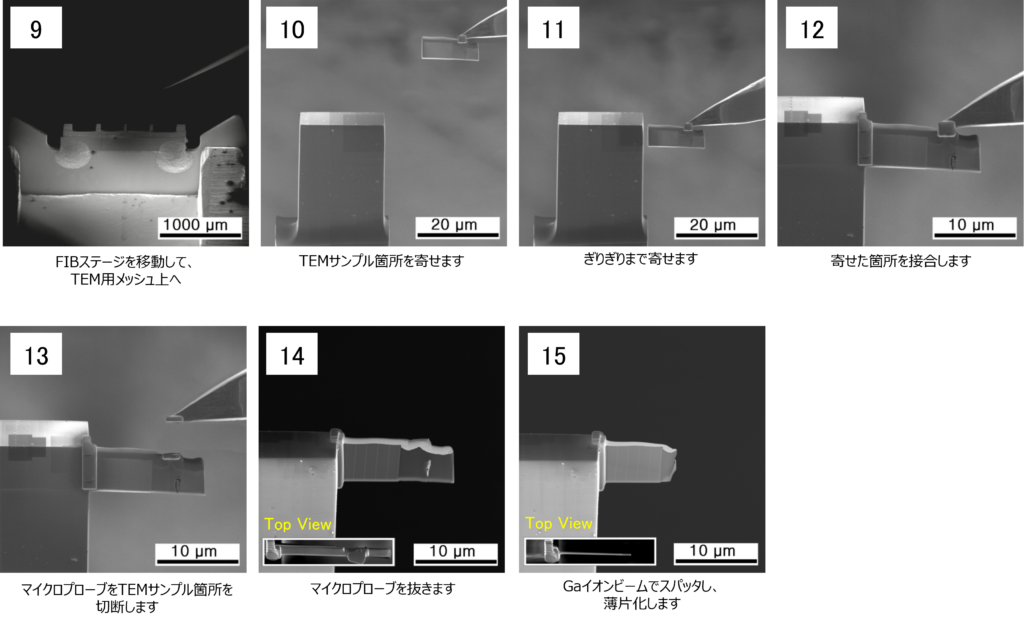
透過電子顕微鏡(TEM)の観察は、観察対象とするサンプルを約100nm以下の厚さに加工しなければ電子が透過しないことから、観察、分析をすることができません。
集束イオンビーム装置(FIB)で観察対象を薄片化することにより、TEM試料を作製することができます。また、局所箇所をピンポイントで加工することも可能です。
<使用機器> 集束イオンビーム装置(FIB)
<納 期> 担当職員にお問い合わせください。
<マイクロサンプリング法 加工例>