低エネルギーイオンミリングを用いた化合物半導体の高分解能観察例
FIBによるTEM試料作製ではGaイオンビームによるダメージ層(~20nm)が加工面に形成されてしまいます。低エネルギーイオンミリング(Arイオンビーム)でGaイオンビームのダメージ層を除去し※、化合物半導体の構造を可視化することができます。
※Arイオンビームによる数nmのダメージ層あり
<使用機器>
分析透過電子顕微鏡(FE-TEM/EDS)
集束イオンビーム装置(FIB)
低エネルギーイオンミリング装置(Gentle Mill)
<測定手順>
①FIB-マイクロプロービング法による断面試料作製
↓
②低エネルギーイオンミリングによるダメージ層の除去
↓
③TEMによる断面試料の観察
※ダメージ層の除去状況により、②、③の作業を複数回行います。
①→②→③→②→③→②→③・・・・
<納期>
担当職員にお問い合わせください。
<測定例>
測定例1 (AlGaAs/GaAs)
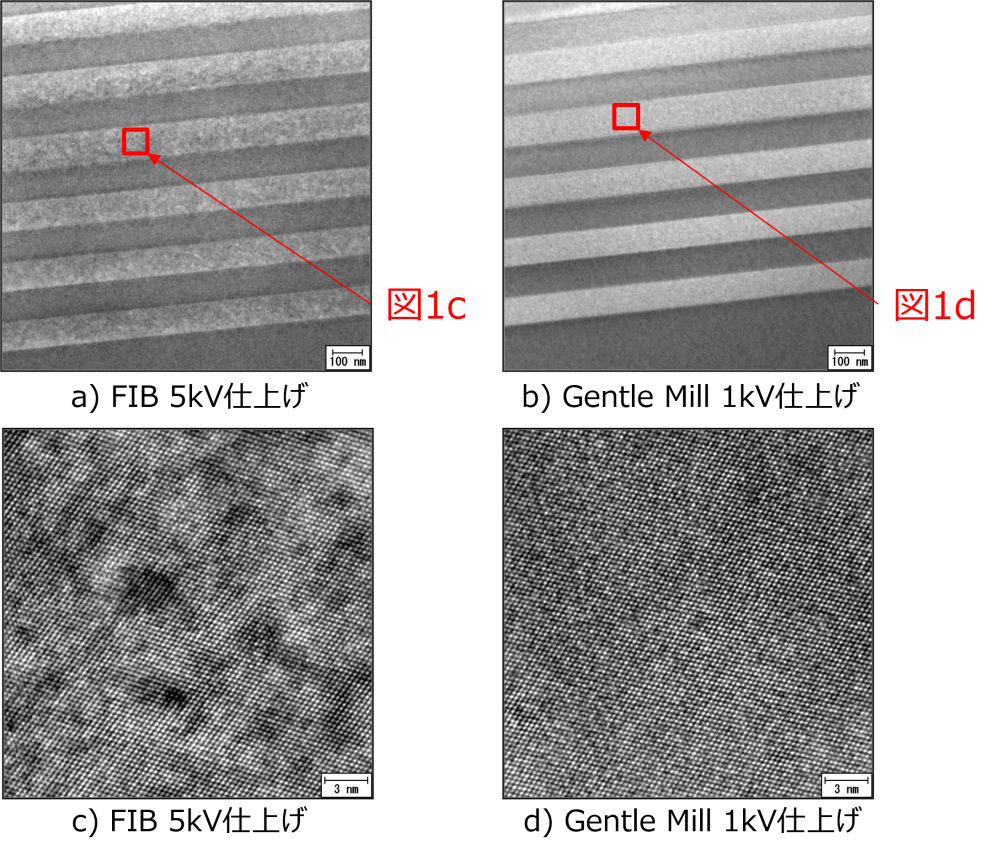
(ダメージ層を除去することで鮮明なTEM画像が得られます。)
測定例2 (GaN)