過去の経常研究成果
- 次世代半導体に向けた有機インターポーザ開発用TEGの開発
- 5Gを活用した多入力リアルタイム遠隔モニタリング
- 樹脂系材料の劣化に対する化学的総合診断への試み -バイオプラスチックへの適用-
- 機械学習を用いた切削加工面の粗さ予測に関する研究
- 最先端無線通信のヘルスケアへの導入に向けた電磁環境に関する研究
- マイクロカンチレバー法による水熱処理したジルコニアセラミックスの劣化評価
- 光触媒反応における中間生成物の分析と人工光合成材料の性能評価に関する研究
- NCフライス加工機の異常診断AIシステムの開発
- 試作用ナノインプリント用金型についての検討
- ミリ波帯のソフトウェア無線機・ソフトウェアアンテナの研究開発
- 人工オパールの陶磁器への応用
- 光コヒーレンストモグラフィーによる錠剤の液中崩壊挙動のその場観察
- 次世代フレキシブルデバイスのための固体レーザーを用いたレーザーリフトオフ技術の開発
- 光触媒の性能向上のための基礎研究 〜比較用試験片の作製〜
- 化学発光測定による プラスチックの劣化評価
- 画像データを活用した遠隔操作ロボッ トに関する研究
- 周波数変換器によるミリ波帯IoT 機器 の評価技術の検討
- 材料に吸着した臭気成分等の分析試験法および その可視光応答光触媒による分解性能試験法の確立
- 機能性食品の抗糖化評価方法の検討
- ビーム照射による機能性薄膜の 加工技術の研究
- 実用的潤滑剤による潤滑下DLC 膜の 摩擦摩耗特性評価
- レーザ肉盛部品のドライ切削に関する研究
次世代半導体に向けた有機インターポーザ開発用TEGの開発
研究期間:令和6年4月〜令和7年3月
実施場所:海老名本部
研究担当:電子技術部 電子デバイスグループ
研究概要
1.背景
近年、半導体分野において、設計コストの増大に対応するため、デバイスを積層し高性能化を可能とする3次元や2.5次元積層実装が行われ、使用される伝送路についても高周波化(10GHz)が求められています。そのため、高周波化に対応する低誘電率、低誘電正接である有機材料が注目されており、CPU-メモリ間を繋ぐインターポーザへの適用が望まれています。また、国内には材料・装置メーカーが複数存在しますが、評価用TEG(Test Element Group)の調達は容易ではなく、簡易に利用できるTEGの研究開発も求められています。
そこで、次世代半導体に向けた有機インターポーザ開発用TEGの実現を目指し、KISTECと東京都市大学が共同で、本事業を実施しました。
研究成果と今後の取組
2.実施内容
まず、樹脂材と金属薄膜の密着性を確認するため、既存フォトマスクを利用し、スパッタ法によるプロセス確認を実施しました(図1 (a))。その結果Si上への配線形成では剥離が発生せず、レジスト上の配線形成では剥離が発生することが分かりました(図1 (b))。この問題に対しては、今後、配線作製プロセスの見直しを含め、対応していく予定です。
また、Si上の配線形成状態についてリフトオフを実施し、ライン&スペースを確認した結果、3μm幅まで作製可能なことがわかりました(図1 (c))。
一方、東京都市大学においては、コプレーナ線路のクロストーク評価を電磁界シミュレーションにより実施しました(図2)。ここでは、配線幅15μm、配線長 1mmとしノイズの影響を最大にするため、実際の配線形成で最小線幅であった3μm、18μmピッチでCPW(コプレーナ線路)とCPWG(グランド付きコプレーナ線路)の比較を行っています。その結果、周波数10GHzまでの範囲では、一般的なCPWGを使用し20μmから55μmピッチ、クロストーク20dB以下が実現できることが分かりました。
最後に、有機インターポーザ作製のため、電気特性評価を実施可能なフォトマスクの設計を行いました。その際、半導体関連企業と打ち合わせ結果を踏まえ、初期の15μm線幅に加えて、より微細な数μmの幅の配線パターンを追加しています。
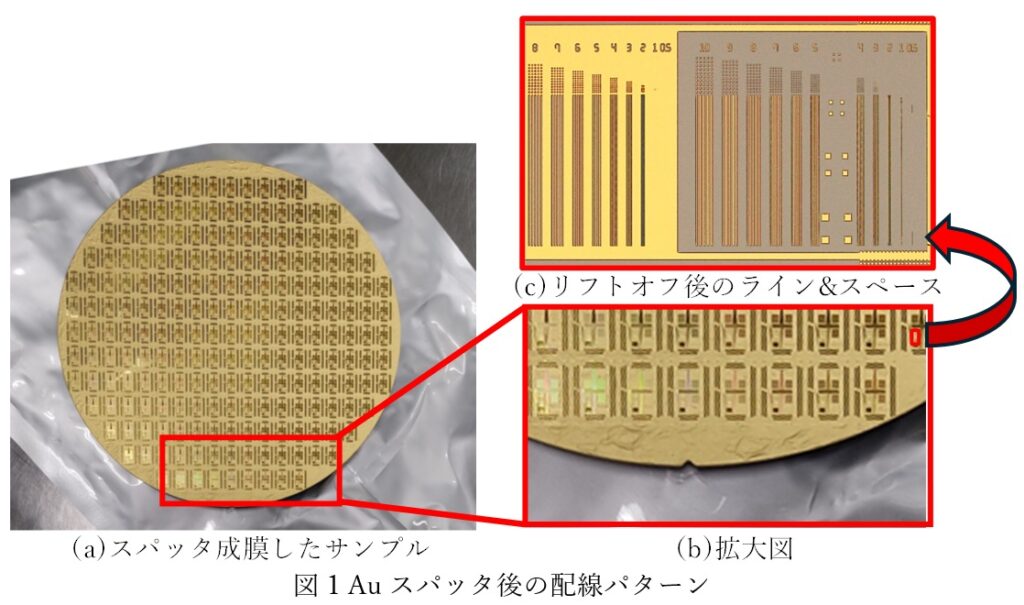
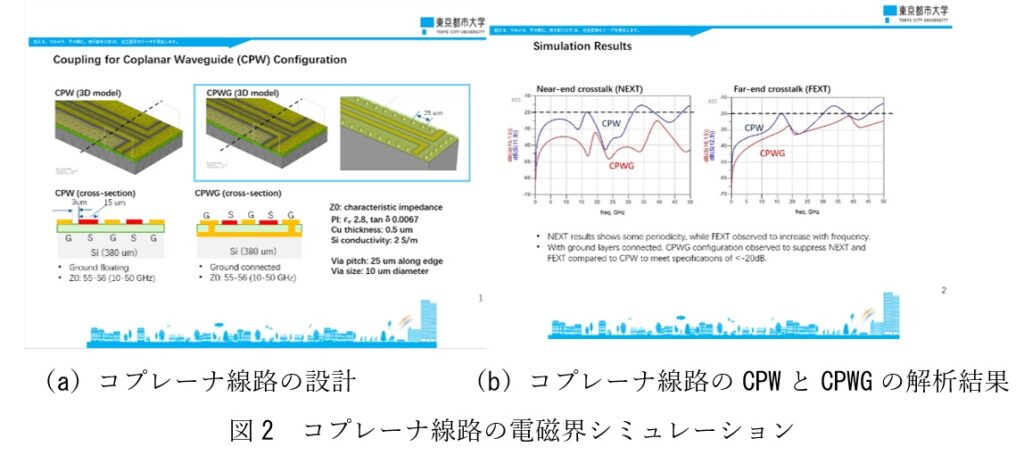
3.成果の展開
本事業終了後、作製したフォトマスクを図3に示します。このフォトマスクには伝送路とクロストーク評価用のパターンを有しており、材料を提供いただき、配線を形成することで電気特性評価を行うことが可能です。
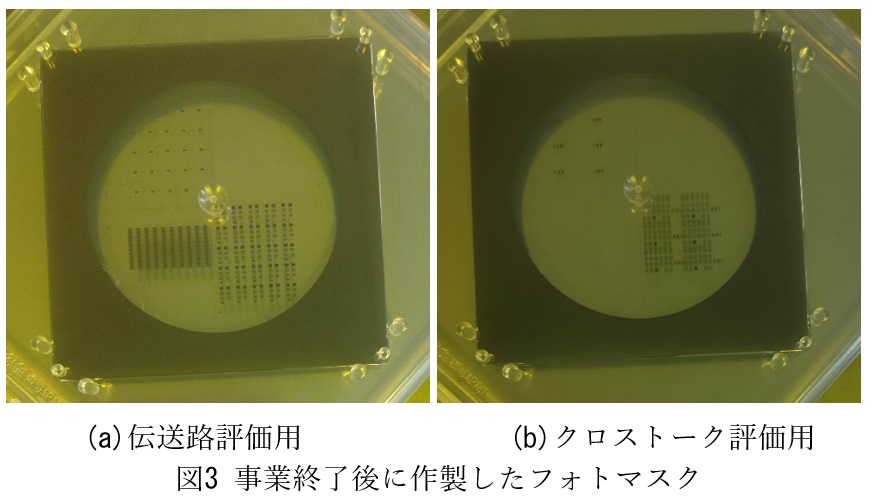
5Gを活用した多入力リアルタイム遠隔モニタリング
研究期間:令和3年 4 月~令和4年3月
実施場所:海老名本部
研究担当:情報・生産技術部、企画部経営戦略課
研究概要
KISTECでは、IoTを「知る」・「試す」・「使う」・「育てる」・「守る」をステップに、中小企業の皆様へIoT技術導入に向けた支援を行っています。また、県内企業等のDX推進や今後のSociety 5.0や第四次産業革命の実現を見据え、工場のIoT化やスマート化など産業分野での活用も期待されるローカル5G等の無線通信の環境を整備しています。
高速・大容量の第5世代通信として注目される5G通信により、画像を含めた多地点での情報をリアルタイムで利用する遠隔監視システムを構築することで、5G通信の特性を把握するとともに、ローカル5Gの利活用に資する知見の蓄積を進めます。

研究成果と今後の取組
製造現場に見立てた当所内の施設において、ローカル5Gで接続された台車ロボットやロボットアーム、環境カメラ、IoTデバイスを用いて、工作機械等の生産設備を遠隔監視・操作するシステムを構築しました。そのシステム構築と動作確認により、ローカル5Gの特性や、ローカル5Gを用いるシステムを構築する際の留意点を把握できました。今後ローカル5Gの普及啓発や技術支援等を進める上で有用な知見を得ることができました。

その他
この事業はKEIRINの補助を受け実施しました。

樹脂系材料の劣化に対する化学的総合診断への試み -バイオプラスチックへの適用-
研究期間:令和3年4月〜令和4年3月
実施場所:海老名本部
研究担当:化学技術部 バイオ技術グループ
研究概要
1.背景
樹脂系材料の劣化に関する相談は年間通して数多くいただきます。お客様は、状態分析に加え、劣化原因を究明し、改善策を得ることを期待されています。しかし、個別の評価手法のみでは、状態について限られた評価しかできず、また原因究明は非常に困難です。
企業においては不具合対応の間、製造や開発が停止せざるを得ない場合も多いことから、企業が迅速に不具合対応できるよう、樹脂系材料の劣化について、適切な評価・診断手法を総合的に提案・実施し、原因究明につながる情報を提供することが求められております。
また、近年、低炭素社会の実現に向けた取り組みとして、植物由来原料を活用したバイオプラスチックやリサイクル材の積極的な利用が進められており、これら材料に係る総合的な劣化解析へのニーズは今後高まると考えられます。
2.目的、概要
本研究では、プラスチック部品、塗料など、樹脂系材料の劣化について、原因究明につながる情報を企業に提供するため、種々の化学的手法を組合せて、劣化を総合的に評価、診断する手法について検討します。我々は、これまで、樹脂グレージング材を対象に、樹脂の機械的特性や加水分解性などの化学的性質の違いを考慮して、劣化の各ステージに応じた評価分析手法を選択する必要性を明らかにしてきました。
今年度は、低炭素社会の実現に資する環境配慮型材料として、今後さらに利用がすすむと予測されるバイオプラスチックのひとつである、ポリ乳酸を対象としました。
具体的には、ポリ乳酸について促進耐候性試験を行い、一定期間経過ごとにサンプリングし、各劣化サンプルについて、引張試験、熱分析、フーリエ変換赤外分光測定、飛行時間型質量分析などの各種測定を行い、状態分析、解析を実施しました。
各評価法で観測された事象と、劣化を確認できた暴露時間を表1に示しました。
引張試験は、強度低下として、劣化を直接的に確認できる方法ですが、各成形品の様々な形状での等しい評価は難しい場合があります。実製品に適用しやすい劣化指標としては、分子量と、熱特性が候補として有望と考えられます。
一連の研究を通じ、バイオプラスチックをはじめとする低環境負荷型材料、樹脂系材料の劣化にかかわる試験計測技術の一層の充実をはかっていきたいと考えています。
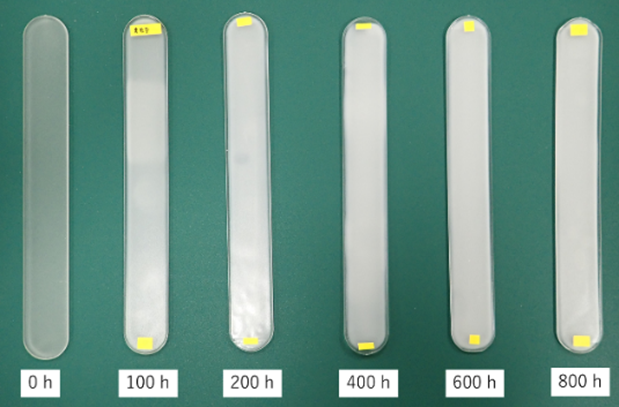

機械学習を用いた切削加工面の粗さ予測に関する研究
研究期間:令和3年6月〜令和4年3月
実施場所:海老名本部
研究担当:情報・生産技術部 試作加工グループ、システム技術グループ
研究概要
生産現場では人手不足が深刻化しており、経験の少ない非熟練者が加工等の作業を行う必要性に迫られています。切削加工において、図面で指示される面粗さを実現するために非熟練者が加工前に適切な切削条件を決定することは容易ではありません。そこで本研究では、非熟練者の加工作業の支援ツール作成を目的に、エンドミル加工においてびびり振動の判定と加工面粗さの予測が可能な機械学習モデルを構築しました。
研究成果と今後の取組
立形マシニングセンタを用いたスクエアエンドミルによる側面切削実験(図1)を実施し、種々の切削条件における加工面粗さ及び加工中の加速度、切削抵抗、温度のデータを収集しました。これらのデータを元に、びびり振動の判定と算術平均粗さ(Ra)の予測を行う機械学習モデルを作成しました。
図2は、機械学習によるびびり振動判定の結果です。90%以上の正解率でびびり振動の判定をすることができています。また図3は、びびり振動の無い加工条件に対して機械学習により面粗さRaを予測した結果です。面粗さRaを0.8μm以下、0.8μm超1.6μm以下、1.6μm超の3つのクラスに分類する形で予測したところ、予測精度は約77%となりました。
びびり振動判定については、精度の高い機械学習モデルを作成することができました。しかし面粗さ予測については実用できる精度ではないため、今後はハイパーパラメータの調整や説明変数の最適化により、予測精度の向上に取り組む予定です。
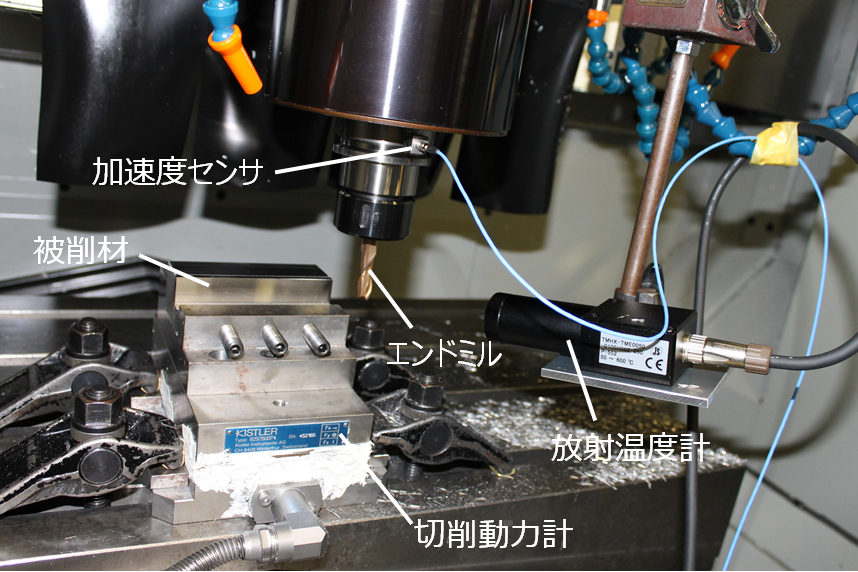

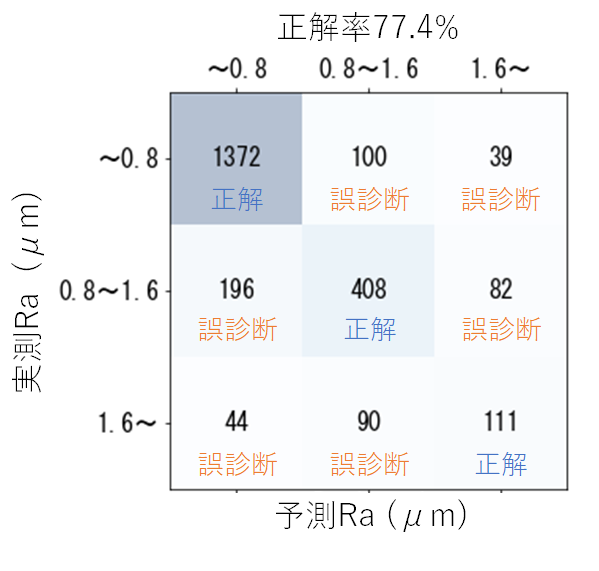
最先端無線通信のヘルスケアへの導入に向けた電磁環境に関する研究
研究期間:令和3年4月〜令和4年3月
実施場所:海老名本部・北里大学相模原キャンパス
研究担当:電磁技術部 電磁環境グループ、北里大学 医療衛生学部
研究概要
近年、低消費電力かつ長距離伝送を可能とする無線通信技術として、LPWAが注目されている。医療現場においては、温湿度管理や医療機器の稼働状態の把握などにLPWAが用いられつつある。特に、COVID-19が蔓延する現代の医療環境においては、非接触でのモニタリングに対する需要は高い。LPWAの代表格であるLoRaWAN(以下、LoRa)は、免許不要であり、最大出力20 mW、日本国内では920 MHz帯を用いて使用が可能である。本研究では、LoRaの医療現場での応用の可能性を検討するとともに、導入に向けた課題を検討したので報告する。
本研究では、遠隔で温湿度と心拍数をモニタリング可能なシステムを試作した。システムは子機(センサ部)と親機(ゲートウェイ)で構成される。子機はLoRaの無線チップを搭載したArduinoベースのマイコンを用いて、温湿度と心拍データを親機へ無線伝送する。親機は受信したデータを外部のアプリケーションサーバ(TTN)と連携させ、遠隔にデータを可視化できる仕様とした。また、LoRa最適な通信パラメータの検討のため、送信時のデータレートおよびペイロードフレーム値を変更させた際のLoRa通信の受信の可否を模擬環境で検討した。
試作したシステムでは、病棟を模擬した同一階のほぼすべての箇所において、親機と子機間で安定した通信が可能であった。データレートとペイロードフレーム値は小さい程、受信の成功率が高い結果となった。
LoRaでは長距離伝送のための周波数拡散技術が採用されているが、拡散率を高めると大容量データの送信はできなくなる。一方センサデータは、2桁の整数値であれば1 byteで済むため、複数のセンサデータを一つの子機が送信する場合でもそこまで大きなデータ量にはならない。今回試作したシステムは医療機器ではないが、自宅やホテル療養などの非医療機関において、簡易的なモニタリングに応用可能であることを示した。


図 試作したモニタリングシステムの概要
マイクロカンチレバー法による水熱処理したジルコニアセラミックスの劣化評価
研究期間:令和3年4月〜令和4年3月
実施場所:海老名本部
研究担当:機械・材料技術部 材料物性グループ、川崎技術支援部 微細構造解析グループ
研究概要
3 mol%-Y2O3安定化正方晶ZrO2セラミックス(Y-TZP)は優れた機械的特性を有するため、光ファイバー端子や精密部品、歯科臨床応用などに広く実用化されています。しかし、100℃以上の熱水や高温の水蒸気に曝されると、表面近傍で正方晶から単斜晶への相転移が起こり、機械的特性が著しく低下する水熱劣化(Low Temperature Degradation: LTD)が起こることが知られています。LTDは表面近傍で起きる現象であるため、従来のマクロな強度試験方法では、その影響を直接的に評価することはできませんでした。本研究では、表面近傍におけるメソスケール(サブμm~数十μm)の機械的特性を「直接」かつ「ピンポイント」で測定可能なマイクロカンチレバー試験を用いて、LTDが機械的特性に及ぼす影響を精緻に評価することを目的としています。
研究成果と今後の取組
図は、1500℃で焼成して作製した試料と、これを水熱処理(HT)した試料それぞれの表面にマイクロカンチレバー(微小な片持ち梁状)試験片(幅1μm、長さ12μm、高さ)を作製し、ナノインデンテーション装置で曲げ試験を実施して取得した荷重変位曲線です。未処理の試験片は、変位の増加とともに荷重が線形に増加した後、非線形に変形して破壊する挙動を示す一方、水熱処理した試験片は、変位の増加とともに荷重が線形に増加する過程で破壊に至っており、強度が大幅に低下(本試料の場合、約62%まで低下)することが明らかになりました。また、破面形態の違いから、HTによりY-TZPの粒界強度が低下することを示唆する結果が得られました。今後は、結晶方位を特定した単一の粒子や粒界にフォーカスした試験を実施し、LTD初期に起こる現象の解明を進めていきます。
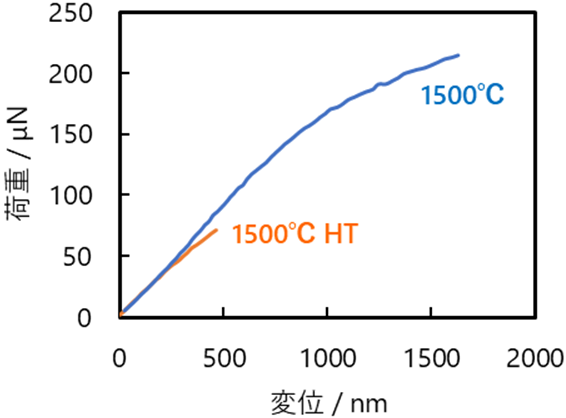
光触媒反応における中間生成物の分析と人工光合成材料の性能評価に関する研究
研究期間:令和2年4月〜令和4年3月
実施場所:溝の口支所
研究担当:川崎技術支援部 材料解析グループ
研究概要
近年、空気汚染の多様化、深刻化に伴い、光触媒の空気浄化分野への応用が期待されています。また、光触媒の性能評価では、空気浄化の観点から対象物質の完全分解が望ましく、中間生成物の正確な分析が課題です。そこで、本研究では、捕集管による溶媒抽出法を用いて、各種反応における中間生成物の分析を行いました。また、今後の光触媒の展望として、人工光合成分野での活用があります。現段階では、基礎研究レベルの検討ですが、成功したときのインパクトは大きく、この分野のご相談や試験ニーズは年々増加傾向にあります。本研究では、可視光応答型光触媒であるCdS/SiC複合体をターゲットに、その水素生成能の評価も併せて実施しました。
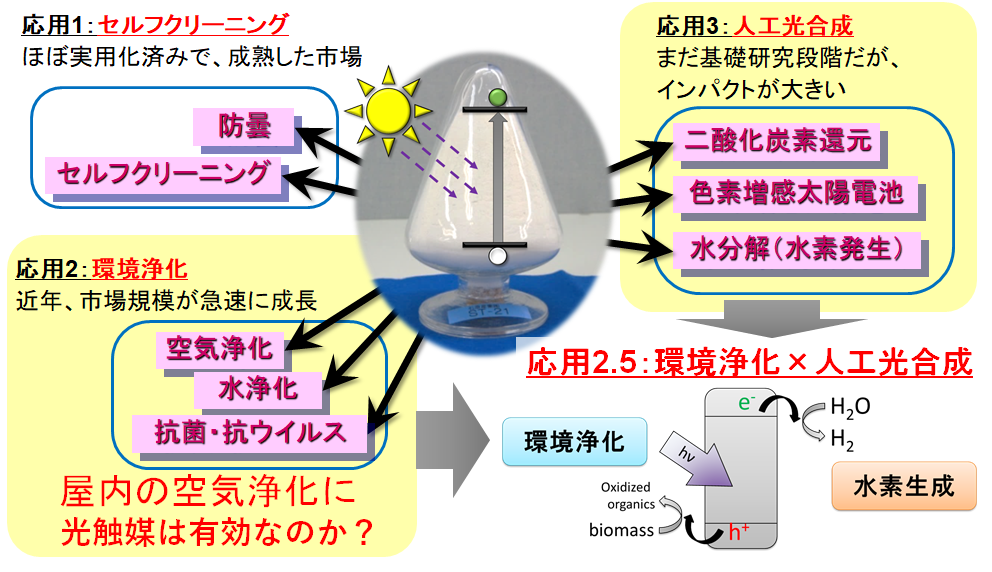
研究成果と今後の取組
中間生成物の評価では、光触媒とオゾンの併用について検討しました。その結果、オゾンによる酸化分解に比べて、光触媒反応では中間生成物の生成量が少ないことが分かりました。また、両者を併用することで、効果的に対象物質が分解されることが示されました(図2)。本研究は、CO2生成量を追う従来の性能評価に比べて、反応機構に踏み込んだ性能評価を実現し、光触媒製品の開発、耐久性などの品質管理への応用が期待できます。
また、水素生成能の評価では、2種類の評価方法を検討しました。従来の閉鎖式試験に比べて、開放式(通気式)試験は操作性が良く、簡便な性能評価が可能で、尚且つ内圧等の影響を受けず、定常的な水素生成を確認することができました(図3)。本研究は、光触媒に関する性能評価技術の裾野を広げ、人工光合成分野のご相談、試験ニーズのための基礎研究に位置付けられます。

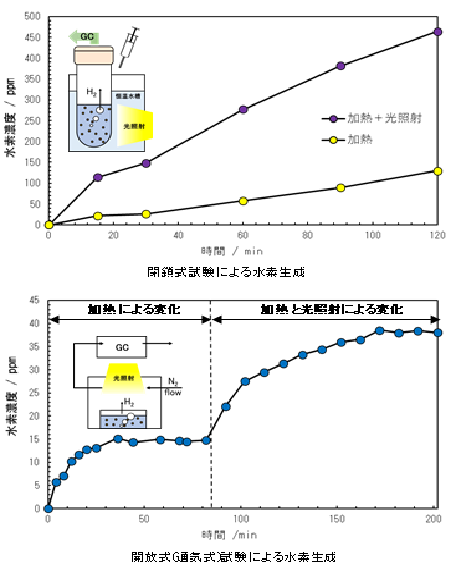
NCフライス加工機の異常診断AIシステムの開発
研究期間:令和2年4月〜令和3年3月
実施場所:海老名本部
研究担当:情報・生産技術部 システム技術グループ 試作加工グループ
研究概要
NCフライス加工機での切削加工において、切削工具の摩耗による劣化や加工条件が不適切な場合には、ワークの加工面の仕上がりの低下、切削工具の折損、加工機の故障に結びつくことがあります。本研究では、切削動力計などの高価な装置を使用せずに、NCフライス加工機から取り出せるデータと、簡易に接続できる電流クランプで取得した電流値を利用して、安価なシステムで異常診断を実現できることを目的としました。合わせて、切削条件とNCフライス加工機から取得したデータを用いて、機械学習により加工面粗さを予測することを試みました。
研究成果と今後の取組
NCフライス加工機から取得した電流値などのデータをネットワークに接続されたパソコンで取得できるシステムを構築しました(図1)。取得した電流値波形により、工具の破損を検知可能であることを明らかにしました(図2)。
また、取得したデータを用いて機械学習(ランダムフォレスト)により加工面粗さを予測する学習モデルを構築しました(図3)。
今後は、加工面粗さの予測精度向上を目指して、ニューラルネットワークを用いた解析を実施する予定です。

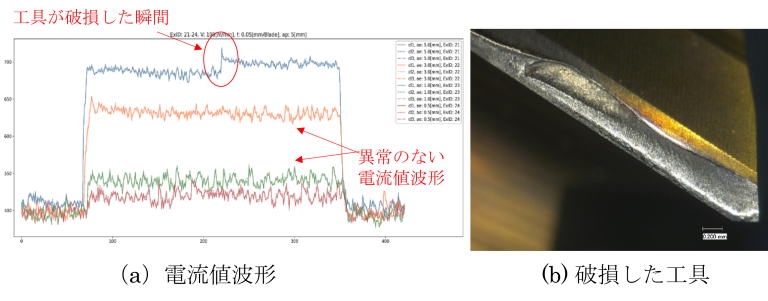
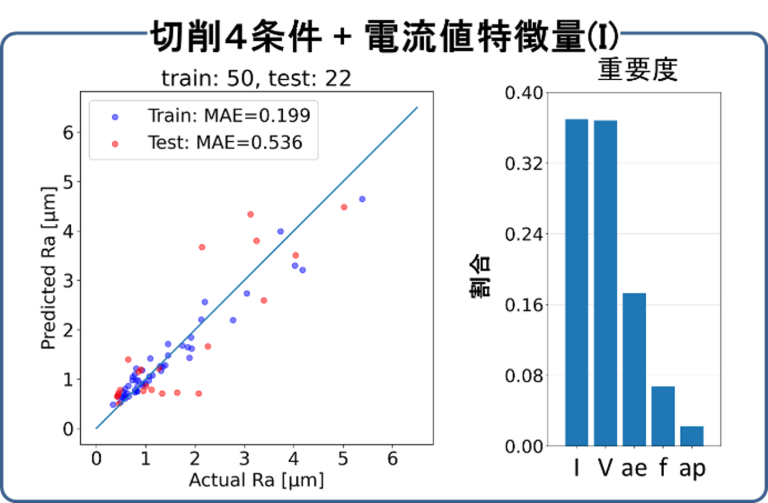
試作用ナノインプリント用金型についての検討
研究期間:令和2年4月〜令和4年3月
実施場所:海老名本部
研究担当:電子技術部 電子材料グループ
研究概要
写真撮影で生じるゴーストやフレアを抑制する無反射構造体、表面に形成した周期的なナノ構造(ナノ周期構造)による構造色など表面にナノ構造体を形成することにより、光学的な機能や親水性、疎水性などを表面に付与できます。また、ナノ周期構造により、疎水性を示す材料表面を親水性へ、親水性を示す材料表面を疎水性へ表面の特性を変えることが可能です。更に、絶縁材料の表面に金属製ナノ周期構造を形成することで、局在表面プラズモン共鳴と呼ばれる微弱な光の強度を著しく増幅させる現象が起こります。この現象は、バイオセンサなどに利用されています。
研究成果と今後の取組
これらのキーワードとなるナノ周期構造を簡単に形成する技術として、ハンコのように金型上の微細な形状を樹脂などの粘弾性体に転写するナノインプリント技術が注目されています。しかし、ナノインプリント技術に用いる金型の製造には、製造コストがかかる半導体技術を多く使用するため、金型作製の工程数を削減する必要があります。ナノインプリントを用いた製造試作ラインの構築ではいかに金型の作製費用を抑えることが重要な課題となっています。
本研究では、シリコンを含有する樹脂に電子線リソグラフィを行い、金型上にナノ周期構造部分を形成し、金型の製造コストを下げることを目指しました。そして、シリコンを含有する樹脂の一種である水素シルセスキオキサン(Hydrogen Silsesquioxane:HSQ)に弊所電子線描画装置(ELS-S50)を用いて電子線描画を行い、金型を試作しました。その結果、令和2年度に用いた籠型構造のHSQ は垂直壁を形成できましたが、令和3年度に用いた梯子型構造のHSQでは、写真に示すように半球状になりやすいことが分かりました。なお、試作した金型を用いて、熱可塑性樹脂であるシクロオレフィンポリマー(Cyclo Olefin Polymer:COP)にナノインプリントを行った結果、ナノパターン転写が可能なことを確認しました。本研究成果の一部は今年2月発行の技術情報誌である“型技術”に掲載されましたa)。
今後は、ナノインプリント技術を用いた製品開発などの技術支援に取り組む予定です。
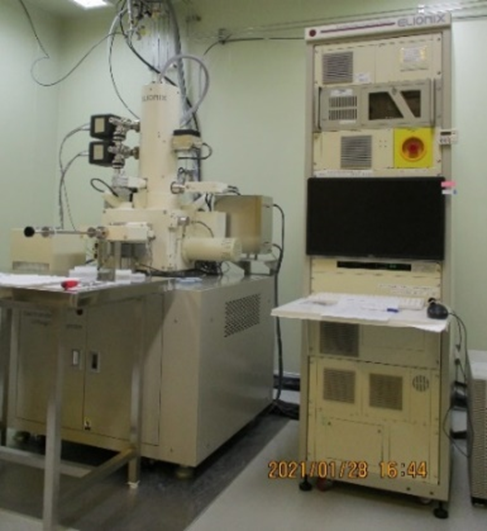
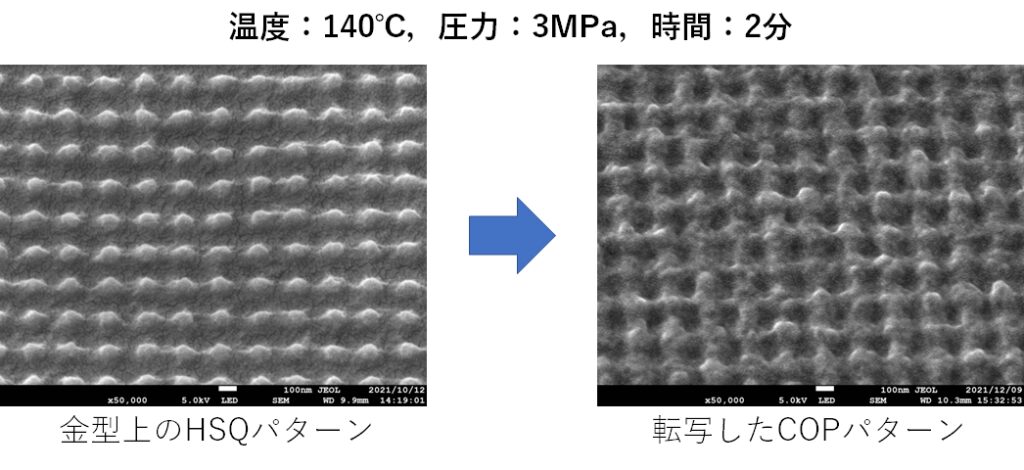
参考文献 a) 安井学、黒内正仁、金子智、三橋雅彦、HSQを用いた試作用ナノ金型の検討、型技術、第37巻、2号、68-71ページ(2022年2月発行)
ミリ波帯のソフトウェア無線機・ソフトウェアアンテナの研究開発
研究期間:令和2 年 4 月~令和3年3月
実施場所:海老名本部
研究担当:電子技術部 電磁環境グループ
研究概要
神奈川では、県内に立地する研究開発型企業や理工系大学などで「神奈川R&D推進協議会」を組織し、電子機器産業をはじめとする高付加価値型産業の振興を目指しており、KISTECも公設試としてその一翼を担っています。
ハイビジョン(2k)を非圧縮で伝送できる伝送速度(1Gbpsから2Gbps程度)に設定し、アンテナ・高速ADC/DAC・FPGAなどを活用することで、ソフトウェア化を通じた小型化・低コスト化を支援します。

研究成果と今後の取組
無線関連技術は、一般的に専門性が高く、技術開発・製品化の大きな参入障壁となっています。しかしながら、本事業において、ミリ波帯の高い周波数であっても、アンテナ・無線をソフトウェアにより構築可能であることが実証できたことで、多くの業種業態が手軽に参入可能であることが示されました。
本ソフトウェア無線技術・ソフトウェアアンテナ技術を導入すれば、既存の多くの無線通信を容易に実現することが可能となります。
今後、共同研究先をはじめ国内メーカーが求めている無線機開発を加速化させる技術を、弊所から提供できる支援体制が構築できました。

その他
この事業はKEIRINの補助を受け実施しました。

人工オパールの陶磁器への応用
研究期間:平成31年4月〜令和3年3月
実施場所:海老名本部
研究担当:機械・材料技術部 ナノ材料グループ
研究概要
オパールの微構造と発色を模倣した「人工オパール」を陶芸用の顔料として応用する、女子美術大学との共同研究です。人工オパールは1/1000ミリメートル以下の微粒子から構成され、その充填構造が特定の色の光を強め合うように反射すると、色を発現します(構造色:図1)。
人工オパールの分散液(図2(a))を絵具のように塗るだけで色を発現し、従来の陶芸技法に馴染むように実用化することを意識しました。いかに粒子の大きさを揃えて規則正しい周期構造を形成させるかが重要なポイントです(図2(b))。
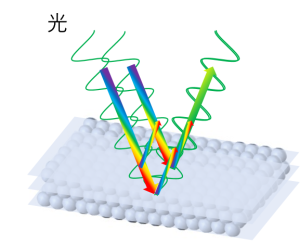
<人工オパールの特徴>
●サステナブル素材
砂や窓ガラスの主成分である酸化ケイ素で、紫、青、緑、黄、赤等の色を発現します。
●これまでにないデザイン
国宝「曜変天目茶碗」のような、光の角度によって色が変わる発色が可能です。
●低コスト
お茶碗試作1つあたりの人工オパール材料費は約10円です。
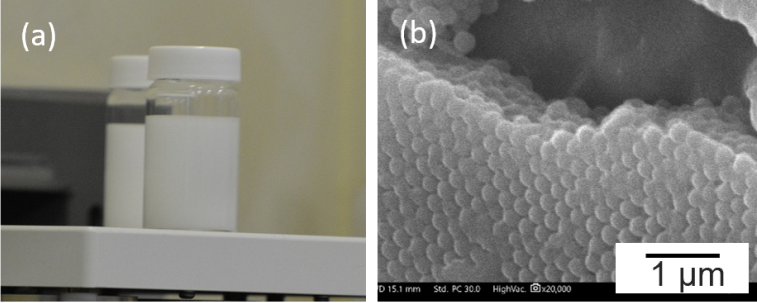
研究成果と今後の取組
光の正反射と拡散反射のバランスを調整し、光の角度によって色が変わる発色と、従来顔料のような角度依存性の無い発色をコントロールすることができました。粒子の隙間を原料の未反応成分で埋めて海島構造を形成し、花器等のインテリアとして使用できる程度に、人工オパールを陶磁器の表面に焼き付けることができました(図3)。技術移転先を募集しております。KISTECメール技術相談フォームより、お問合せ下さい。

粒径によって色が異なる。
(b)曜変天目の色をモチーフとした作品
光コヒーレンストモグラフィーによる錠剤の液中崩壊挙動のその場観察
研究期間:令和2年4月〜令和3年3月
実施場所:海老名本部
研究担当:機械・材料技術部 材料物性グループ
研究概要
錠剤は、医薬品や機能性食品等の定番剤型です。特に医薬品では、狙った場所やタイミングで人体に薬剤を吸収させるため、崩壊性の的確な制御と品質管理が求められます。このため、崩壊現象の実態の理解は極めて重要です。本研究では、波長掃引型光コヒーレンストモグラフィー(SS-OCT)を基軸に、錠剤が吸水して崩壊に至るまでの内部構造変化の過程を動的に非破壊観察し、外観変化や重量変化の同時測定を両立するための評価システムを新たに構築するとともに、画像解析で内部構造変化過程を定量的に可視化することを目的としました。
研究成果と今後の取組
図は、市販錠剤の内部構造変化過程の定量解析結果です。構造敏感なスペックルパターンの変位量をデジタル画像相関法で解析することで、構造変化の大きさや位置に関する情報を可視化できました。本研究より、錠剤と水が接触すると、錠剤自身の毛細管力によって吸水が起こると同時に内部では構造変化が不均質に進行し、水が浸入しづらい領域は様々な大きさの塊となりやがて水中に散開していく、という崩壊過程を重量変化と直接関連付けて明らかにすることができました。本成果は、所望の薬効性を発現するための定量的な錠剤設計の重要な基盤情報になると考えられます。
今後は、水の経路を決める粒子充填構造と内部構造変化過程の相関関係の解明に取り組みます。

次世代フレキシブルデバイスのための固体レーザーを用いたレーザーリフトオフ技術の開発
研究期間:平成 31 年 4 月~令和2年3月
実施場所:海老名本部
研究担当:電子技術部 電子材料グループ
研究概要
神奈川県では、県内に立地する研究開発型企業や理工系大学など23機関で「神奈川R&D推進協議会」を組織し、電子機器産業をはじめとする高付加価値型産業の振興を目指しており、KISTECも公設試としてその一翼を担っています。「リフトオフ」装置の低コスト化を目的とした光源変更の研究を通じ、一企業ばかりでなく、開発した装置を用いて電子機器を製造する神奈川や日本メーカーのグローバル競争を支援します。
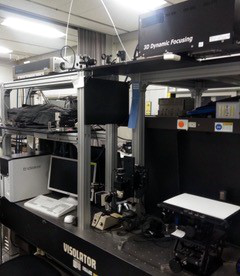
研究成果と今後の取組
本事業によりガラス上のフィルムへ積層された各種デバイスを低コストで効率よく剥離できる設備が実現可能となりました。従来の高価で大掛かりな装置から多品種少量生産の部品でも過剰設備とならないレーザーリフトオフ装置を供給できるようになりました。

その他
事業成果により開発された共同研究企業の製品
株式会社クォークテクノロジー UV-Laser(企業HP)
この事業はKEIRINの補助を受け実施しました。

光触媒の性能向上のための基礎研究 〜比較用試験片の作製〜
●研究期間:平成29年4月〜
●実施場所:溝の口支所
●研究担当:川崎技術支援部 太陽電池評価グループ、材料解析グループ
研究概要
KISTEC では、光触媒に関する各種JIS 試験を行っており、光触媒工業会が定める推奨試験機関となっています。光触媒工業会は、このJIS 試験結果をもとに、性能、利用方法等が適切であることを認めた光触媒製品に対し、PIAJ 認証マークを与えています。そのため、JIS 試験においては、正確で信頼性の高い評価が重要となります。川崎技術支援部では、光触媒材料の空気浄化性能試験を行っており(図1)、安定した測定、性能のばらつきを把握するために比較用試験片の開発を行っています。図2に、比較用試験片についてJIS試験を繰り返し実施し、性能とXPSによる表面状態の比較をした結果を示します。アセトアルデヒド除去率は、約5 %程度のばらつきはありますが安定しており、Tiの含有率とも相関があることが分かります。
また、JIS 試験が、ガスを流通させながらその除去性能を評価するのに対して、テドラーバッグ等に光触媒材料をセットして、その空間の臭気ガスの減衰傾向から光触媒の性能評価する静置型の試験(ガスバッグ法)についても評価を行っています。こちらは可視光での比較用試験片で光源に白色蛍光灯を用いております(図3)。
このように、比較用試験片を開発することにより、規格試験、バッグ試験等の比較用試験片として評価結果の変動を把握するとともに、評価法の条件変動が評価結果に及ぼす影響を調査することが可能となります。


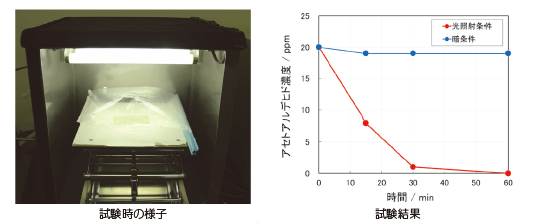
化学発光測定による プラスチックの劣化評価
研究期間:平成29年4月〜平成31年3月
実施場所:海老名本部
研究担当:化学技術部 環境安全グループ
研究概要
プラスチックは熱や光などの作用によって徐々に劣化が進行します。例えばプラスチック劣化促進試験として耐候性試験などが利用されていますが、プラスチックの長寿命化設計により、その試験時間も長時間必要になってきています。そこで比較的短時間の劣化促進時間で、劣化状態を観測(評価)する方法として化学発光測定法が注目されています。本測定法は、プラスチックの酸化劣化によって生成する過酸化物由来の微弱な発光を高感度に検出することができます。
本研究では汎用プラスチックの一つであるポリプロピレンを対象に加熱および光照射処理を施し、試料の劣化を化学発光測定法ならびに従来から劣化評価法として用いられている赤外分光法により評価をしました。その結果、赤外分光法では数十時間処理した試料で初めて劣化の指標となるカルボニル基の生成が確認されたのに対し、化学発光測定法では数時間の処理で発光を確認することができました。検出までの処理時間の違いは、化学発光測定では自動酸化反応の極初期段階に生成する過酸化物由来の発光を観測するのに対し、赤外分光分析では自動酸化反応の進行に伴って生成したカルボニル基を検出することに起因します。本研究はプラスチックの劣化評価期間を短縮する技術として、製品開発、品質管理、安全性評価などへの応用が期待できます。
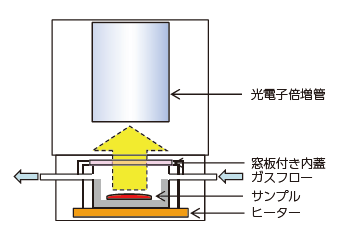
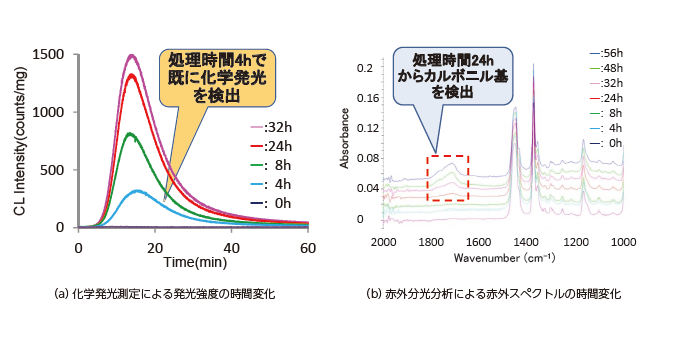
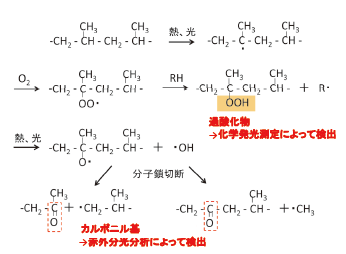
画像データを活用した遠隔操作ロボットに関する研究
●研究期間:平成30年6月〜平成31年3月31日
●実施場所:海老名本部
●研究担当:情報・生産技術部 デザイン・設計グループ
研究概要
ロボットの分野でもIoT で集めたデータの活用が求められています。特に、カメラで入手できる画像データについては多くの応用が期待され、遠隔操作への応用もそのひとつです。遠隔操作では、映像から奥行き位置を正確に知覚できないことが大きな課題です。目標位置と、ロボットの実際の操作結果との間に意図しない誤差が残ってしまい(図1)、操作が困難になっています。そこで私たちは、ロボットの操作難易度(ハードル)を下げ、高齢化・人手不足が進行する中で遠隔操作ロボットをさらに普及させることを目的に、画像データの活用を検討しています。
本研究では、複数台のカメラを有する遠隔操作ロボット(図2)と、複数台のディスプレイを立体的に配置したコックピットを構築しました(図3)。さらに、画像に様々なヴィジュアルエフェクトを付加することで、視覚を最大限に活用した奥行き感覚の増強手法の開発を行いました。その結果、①オプティックフロー(自身の運動や外界の変化に伴って、網膜に投映される光の変化)の情報を活用すると操作者の知覚を変調できる可能性があること、②開発した奥行き指標が遠隔操作の精度向上に有効であること、を明らかにしました。今後は、遠隔操作ロボットの有力な応用先の一つである重機の遠隔操作を想定し、実機を用いた実証実験を通じて効果を評価する計画です。


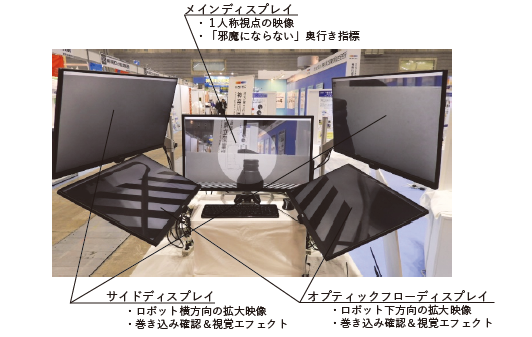
周波数変換器によるミリ波帯IoT 機器の評価技術の検討
研究期間:平成30年4月〜平成31年3月
実施場所:海老名本部
研究担当:電子技術部 電磁環境グループ
研究概要
ミリ波(30GHz 〜300GHz)は、衛星通信・固定無線アクセスを始めとした基幹システムに利用されてきました。しかし、半導体技術などの技術革新に伴い、無線LAN・車載レーダ・人体スキャンなどIoT(Internet of Things)/ EoT(Enterpriseof Things / Edge of Things)機器への用途が期待されます。加えて、ミリ波は、他の周波数帯に比較して空き周波数が多く、異なる活用方法も期待されます。
これまでKISTEC の既存設備ではマイクロ波(3GHz 〜30GHz)まで対応していました。本研究では、廉価な周波数変換器により60GHz-90GHzに対応したミリ波測定システムを構築しました。次に、構築したシステムの基本的な特性であるアンテナパターンと周波数スペクトラム歪みについて説明します。
アンテナパターンはアンテナから送受信される電波の指向性を表すもので、電波暗室内で測定しました。図 1に示す角錐ホーンアンテナのアンテナパターン(63GHz)では、特定方向への電波の放射強度が確認できました。図 2の周波数スペクトラム歪みは、ベースバンド信号(中心周波数が0Hz の直交信号)に対してプラスの周波数側及びマイナスの周波数側に信号が漏れ出すことを意味します(spurious:不要波)。デジタル信号処理前は、図 2( a)に示す通り歪みが生じていましたが( 0Hzの成分と脇の歪み成分の差:38dBc)、処理後は、図 2( b)に示す通り歪みを改善(57dBc)することができました。
廉価な周波数変換器と信号処理技術による簡易的なミリ波測定システムを構築しました。
今後、アンテナ測定・高周波測定・デジタル信号処理などの技術支援を行っていく予定です。


材料に吸着した臭気成分等の分析試験法およびその可視光応答光触媒による分解性能試験法の確立
研究期間:平成29 年4 月~
実施場所:溝の口支所
研究担当:川崎技術支援部 材料解析グループ
研究概要
光触媒を用いた空気清浄器の普及によって、空気中の臭気成分等が光触媒で分解できることはよく知られています。しかし、壁紙や衣服などに吸着した臭気成分等が、光触媒でどれだけ分解できるかについては、光触媒JIS 試験でも評価法が定められておらず、あまり報告もありません。そこで、可視光応答光触媒を担持した不織布を試作し、たばこ煙を吸着させ、その吸着がどの程度分解できるか、GCMS 分析等で評価しました。試作した可視光応答光触媒担持不織布は、吸着臭の脱臭に一定の効果があることを確認しました。なお、本研究成果は東京理科大学と共同で論文等として発表予定です。


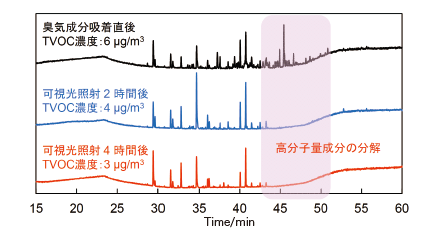
機能性食品の抗糖化評価方法の検討
研究期間:平成29 年4 月~
実施場所:海老名本部
研究担当:化学技術部 バイオ技術グループ
1.研究背景と目的
超高齢化に伴い健康寿命の延伸や未病の改善など健康に老いることが求められています。老化にかかわるストレスの1つとして糖化ストレスがあります。糖化はヒトの体を構成す
るタンパク質がヒトの食事に由来する炭水化物(糖)と反応することで引き起こされるため避けることができず、皮膚老化、動脈硬化などの一因となるといわれています。
この糖化を抑制するための1 つの方法として機能性食品の摂取が挙げられます。
本研究では、機能性食品の抗糖化性評価方法の検討を行い、新たな抗糖化性をもつ機能性食品の開発に寄与することを目的としました。
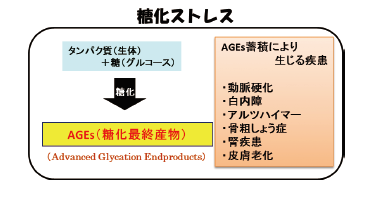
2. 平成29 年度研究結果
これまで当所における食品の抗糖化性評価方法としては主に試験管レベルでタンパク質の糖化最終産物(AGEs)のうち蛍光性AGEs の生成抑制作用を見ることで評価を行ってきました。
本研究では、食品の抗糖化性評価方法として新たに非蛍光性AGEs の1 つであるカルボキシメチルリジン(CML)の生成抑制作用評価方法の構築を行いました。各種植物抽出液を対象としてCML 生成抑制作用評価を行い、本研究で構築した評価法による評価が可能であることを確認しました。今後、本評価法を用いて新たな抗糖化性をもつ機能性食品の開発支援を行っていく予定です。


ビーム照射による機能性薄膜の加工技術の研究
研究期間:平成29 年4 月~平成32 年3 月
実施場所:海老名本部
研究担当:電子技術部 電子材料グループ
研究概要
機能性薄膜は、素子構造作製などを目的として微細加工が行われています。極微細パターンの形成に用いられる電子線リソグラフィには描画パターンの大きさなどにより形成されるパターンサイズとのずれが生じる近接効果の影響により描画条件を予想するのが難しいという課題があります。そこで、単純なパターンを対象とした簡便な近接効果補正の手法について検討しました。 ポジ型の電子線レジストをシリコン基板上に塗布して、周期100nm のラインアンドスペースパターンの形成を行いました。描画条件として、ドーズ量と、描画領域幅/ 非描画領域幅の比率を変えて検討を行いました。
作製したパターンの一例は図1 に示すように高精細なパターンが形成されたことを確認しました。描画条件であるドーズ量x と描画領域幅y と描画領域に対応する開口部幅zの関係を調べた結果(図2)、シンボルで示した実験値に対して、x、y からなるz の2 次近似式でフィッティングを行った結果は実線で示すようになり、実験値によく合う結果となりました。そのため、フィッティング式と得られたフィッティングパラメータから、描画条件x、y に対応するパターン開口部幅z が予想できると考えられます。予想の適用が可能な範囲については、今後検討を行います。

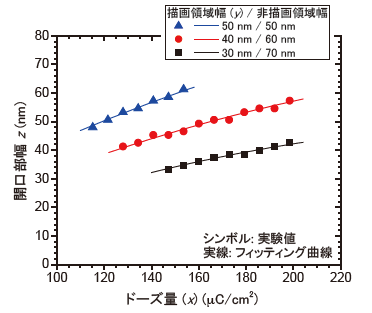
実用的潤滑剤による潤滑下DLC 膜の摩擦摩耗特性評価
研究期間:平成28 年4 月~平成30 年3 月
実施場所:海老名本部
研究担当:機械・材料技術部 材料物性グループ
研究概要
しゅう動性に優れたDLC(ダイヤモンドライクカーボン)膜は、使用する潤滑剤によって摩擦係数が変化することが知られています。本研究ではDLC に対する実用的潤滑剤の候補の一つであるエステル系潤滑剤について、摩擦係数低減効果とそのメカニズムについて調査しました。その結果、水素含有DLC(a-C:H)に比べて水素フリーDLC(ta-C)に対する摩擦低減効果が大きく、エステルの化学構造における炭素鎖の長さ、および分岐の有無によって摩擦特性が異なることがわかりました。摩擦係数が低い場合は、最表層に吸着する物質の炭素−酸素結合の割合が大きく、しゅう動面には元の潤滑剤に比べて10% 程度分子量の大きい物質がより多く吸着していました。この物質は、しゅう動面にトライボ化学反応によって形成され、摩擦低減に大きく影響すると考えられます。本研究は、摩擦エネルギーを減らす環境負荷低減技術として、自動車分野をはじめ、食品、医療、福祉分野等、今後の成長が見込まれる分野への応用が期待されます。
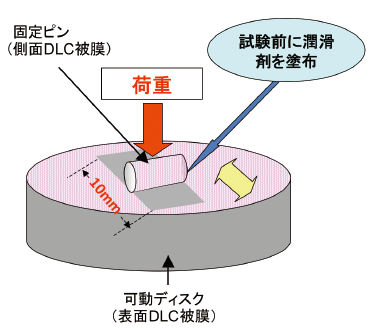
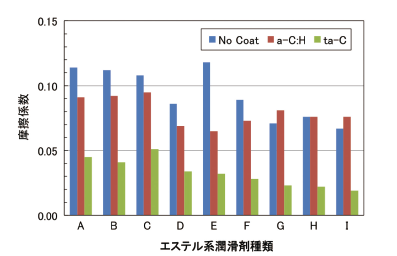
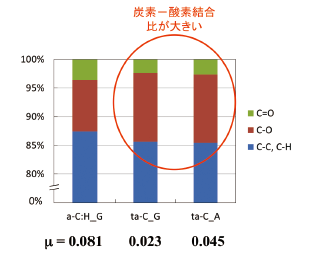

レーザ肉盛部品のドライ切削に関する研究
研究期間:平成 29 年 4 月~
実施場所:海老名本部
研究担当:事業化支援部デジタルものづくり担当 試作加工グループ
研究概要
最近の金属 3D プリンタには、Laser Metal Deposition (LMD・レーザ粉体肉盛)等の技術で素材を積層造形した後、 同じ機械で切削して形状を仕上げる複合加工機が登場してい ます。これらの機械で効率良く部品を製造するには、切削油 剤を用いずドライで切削することが理想的です。しかし、一 般的にドライ切削には工具寿命悪化等の問題があります。そ こで、LMD による素材の被削性を明らかにし、良好なドラ イ切削のための指針を得ることを本研究の目的としました。 レーザ粉体肉盛装置(図 1)で作製した肉盛材(材質 SUS420J1)に対し、ボールエンドミルによる切削を行い、 工具摩耗等を評価しました。肉盛材切削時の工具の摩耗幅は 一般材(生材)切削時より大きく(図 2)、肉盛材の被削性 は焼入れした一般材に近いことが明らかになりました。肉盛 材のドライ切削をウェット切削と比較すると、同等の加工面 が得られ(図 3)、工具摩耗幅も同程度となりました。したがっ て、ドライ切削でもウェット切削と同等の切削が可能である ことが分かりました。さらに、工具、ホルダ、切削条件を変 更して実験し、良好なドライ切削の指針を明らかにしました。